Exhibitors' information
[No.40] Semilab Japan

コメントやご担当者様情報はこちらをクリック
住所:〒222-0033 神奈川県横浜市新横浜2-15-10 YS新横浜ビル6階
Tel: 045-620-7960
https://www.semilab-j.jp/
E-mail: sakuta.t23@semilabjpn.com
▼カタログ(資料)をダウンロードはこちらから
分光エリプソメータ SE-2000DLTSシステム非接触シート抵抗測定装置&移動度測定装置フォトルミネッセンス En-Vison非接触CV測定装置 Cn-CVライフタイム測定装置フォトルミネッセンス WT原子間力顕微鏡 AFM
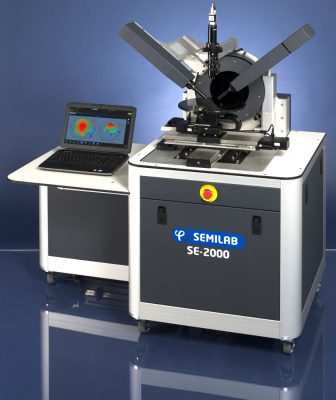
【分光エリプソメータ SE-2000】
エリプソメーターは、サンプル表面から反射された光の偏光の状態変化(ΨΔ)を測定することにより、サンプル(薄膜、基盤)の膜厚値、屈折率、消衰係数を求める光学測定装置です。単層膜から多層膜の各層の膜厚値と光学定数(屈折率、消衰係数)を非接触・非破壊で測定することが可能です。 分光エリプソメーターでは、膜厚値は、サブナノメートルから数十マイクロメートルの範囲で精度良い測定ができ、一般的な酸化膜、窒化膜、フォトレジストを含む半導体材料からディスプレイ用の有機膜や透明導電膜、また金属薄膜や表面粗さ測定まで幅広いアプリケーションでご使用頂いています。
https://www.semilab-j.jp/model/se-2000/
お問い合わせ先: sakuta.t23@semilabjpn.com

【DLTSシステム】
Deep Level Transient Spectroscopy(DLTS)は、汚染(コンタミネーション)や結晶欠陥による半導体中の電気的に活性な欠陥(「トラップ」)の検出と特定を行う強力な技術です。この技術は、深いトラップに関連するエネルギーレベル、捕獲断面積、濃度分布などのあらゆるパラメータを決定するための非常に汎用的な方法です。不純物の特定が可能であり、濃度が2×108 atoms/cm3以下の汚染を検出できます。 DLTSは、ショットキーダイオードまたはPN接合と小型サンプル(通常は完成ウェハーから切断されたもの)との成形を必要とするため、破壊的手法です。
https://www.semilab-j.jp/products/semiconductor-industry/contamination-analysis/dlts/
お問い合わせ先: sakuta.t23@semilabjpn.com

【非接触シート抵抗測定装置&移動度測定装置】
半導体デバイス製造プロセスにおいて、シート抵抗測定はとても重要な検査項目です。シート抵抗マッピングデータは、エピタキシャル成長炉の最適化に用いられ歩留まりの向上に貢献します。 Semilab(旧リハイトン社 Lehighton Electronics, Inc.)のシート抵抗測定装置LEI-1510シリーズは、非接触非破壊でシート測定の測定が可能です。LEI-1510シリーズは、化合物半導体の様々なアプリケーションに対応できるように設計されていて、特に、このLEIテクノロジーによるシート抵抗マッピンググラフは、高周波デバイスの分野において、LEIマップとして広く認識されています。
https://www.semilab-j.jp/products/semiconductor-industry/compound-material-characterization/non-contact-sheet-resistance-eddy/
お問い合わせ先: sakuta.t23@semilabjpn.com

【フォトルミネッセンス En-Vison】
En-Vision(Enhanced Vision)では、転位欠陥、酸素析出物、積層欠陥などのウェハー内部の結晶欠陥を非接触・非破壊で測定できます。通常こうした欠陥は、光学的検査では可視化できません。En-Visionでは、ウェハー深さ方向の検出感度を大幅に向上させ、幅広い密度とアプリケーションをカバーすることで、表面近傍では確認ができない深さ方向の応力起因転位欠陥の検出感度を従来の手法(X-TEM/SECCOエッチング)よりも大幅に向上させています(100倍以上)。 EnVisionは、欠陥サイズ(15nm~サブミクロン)と密度(E6~E10/cm3)の両方でハイダイナミックレンジを提供します。
https://www.semilab-j.jp/products/semiconductor-industry/defect-inspection/en-vision/
お問い合わせ先: sakuta.t23@semilabjpn.com

【非接触CV測定装置】
Semilab SDIのCn-CVシステムは、半導体デバイス・材料の製造プロセス管理と研究開発で使用される最新式で非接触・非破壊の電気メトロロジー装置です。この強力な測定手法では、非接触表面電位プローブ法を照射/非侵襲表面帯電と組み合わせて用いることで、半導体ウェハー、誘電体、界面の特性を示す幅広いパラメータを高精度で測定できる一方で、専用の検査試験装置を製作することに伴うコストと時間を節約できます。 非接触CVプロファイリングメトロロジーの主なアプリケーションは、デバイス製造中の誘電体のモニタリングです。ここで最も重要な機能であり、従来の電気的測定との差別化要因となるのは、事前準備が不要で非接触測定方式であることです。このため、MOSキャパシタの事前準備が不要となり、製造と研究開発の両方の環境で測定コストが削減され、データフィードバックが迅速に実行されます。
https://www.semilab-j.jp/products/semiconductor-industry/compound-material-characterization/non-contact-c-v-profiling/
お問い合わせ先: sakuta.t23@semilabjpn.com

【ライフタイム測定装置】
ライフタイムは、バルク半導体材料の特性の1つであり、過剰キャリアが再結合して平衡に達する前に半導体材料中に存在する平均時間を指します。このパラメータは、「少数キャリア・ライフタイム」、「キャリア・ライフタイム」、「再結合ライフタイム」とも呼ばれます。半導体のライフタイムは、結晶格子が完全で、汚染がない場合に長くなります。一方で、汚染や、導体材料中に不具合がある場合には、ライフタイムは短くなります。このため、ライフタイムをモニターすることが、汚染の検出に効果的です。 セミラボでは、シリコンの他に、ワイドギャップ半導体(SiC,GaN)用のライフタイム測定装置も取り扱っています。
https://www.semilab-j.jp/products/semiconductor-industry/contamination-monitoring/minority-carrier-lifetime-measurement/
お問い合わせ先: sakuta.t23@semilabjpn.com

【フォトルミネッセンス WT】
フォトルミネッセンス測定と反射率測定によりGaN、SiCなどのワイドギャップ半導体中の欠陥と汚染を高速・高解像度で測定する装置です。非接触測定により、LEDなどの品質検査が容易に行えます。
https://www.semilab-j.jp/products/semiconductor-industry/compound-material-characterization/spectral-photoluminescence-measurement/
お問い合わせ先: sakuta.t23@semilabjpn.com
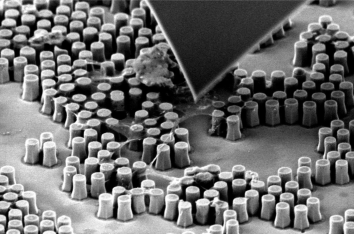
【原子間力顕微鏡 SEM-AFM】
走査型プローブ顕微鏡(SPM/AFM)は、半導体や金属などの微小領域の表面形状や物理量を観察する顕微鏡です。原子間力顕微鏡AFMで、高精度に物質表面の画像が取得できます。SEMとAFMの組み合わせにより、更に高度な解析が可能になります。
https://www.semilab-j.jp/products/research-development/nano-surface-characterization/sem-afm/
お問い合わせ先: sakuta.t23@semilabjpn.com
住所:〒222-0033 神奈川県横浜市新横浜2-15-10 YS新横浜ビル6階
Tel: 045-620-7960
https://www.semilab-j.jp/
E-mail: sakuta.t23@semilabjpn.com
▼カタログ(資料)をダウンロードはこちらから
分光エリプソメータ SE-2000DLTSシステム非接触シート抵抗測定装置&移動度測定装置フォトルミネッセンス En-Vison非接触CV測定装置 Cn-CVライフタイム測定装置フォトルミネッセンス WT原子間力顕微鏡 AFM
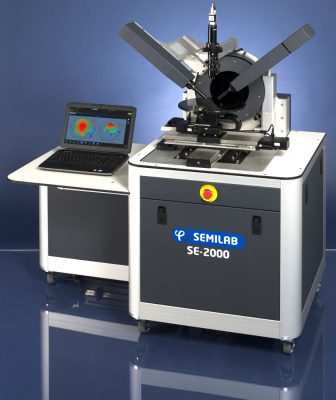
【分光エリプソメータ SE-2000】
エリプソメーターは、サンプル表面から反射された光の偏光の状態変化(ΨΔ)を測定することにより、サンプル(薄膜、基盤)の膜厚値、屈折率、消衰係数を求める光学測定装置です。単層膜から多層膜の各層の膜厚値と光学定数(屈折率、消衰係数)を非接触・非破壊で測定することが可能です。 分光エリプソメーターでは、膜厚値は、サブナノメートルから数十マイクロメートルの範囲で精度良い測定ができ、一般的な酸化膜、窒化膜、フォトレジストを含む半導体材料からディスプレイ用の有機膜や透明導電膜、また金属薄膜や表面粗さ測定まで幅広いアプリケーションでご使用頂いています。
https://www.semilab-j.jp/model/se-2000/
お問い合わせ先: sakuta.t23@semilabjpn.com

【DLTSシステム】
Deep Level Transient Spectroscopy(DLTS)は、汚染(コンタミネーション)や結晶欠陥による半導体中の電気的に活性な欠陥(「トラップ」)の検出と特定を行う強力な技術です。この技術は、深いトラップに関連するエネルギーレベル、捕獲断面積、濃度分布などのあらゆるパラメータを決定するための非常に汎用的な方法です。不純物の特定が可能であり、濃度が2×108 atoms/cm3以下の汚染を検出できます。 DLTSは、ショットキーダイオードまたはPN接合と小型サンプル(通常は完成ウェハーから切断されたもの)との成形を必要とするため、破壊的手法です。
https://www.semilab-j.jp/products/semiconductor-industry/contamination-analysis/dlts/
お問い合わせ先: sakuta.t23@semilabjpn.com

【非接触シート抵抗測定装置&移動度測定装置】
半導体デバイス製造プロセスにおいて、シート抵抗測定はとても重要な検査項目です。シート抵抗マッピングデータは、エピタキシャル成長炉の最適化に用いられ歩留まりの向上に貢献します。 Semilab(旧リハイトン社 Lehighton Electronics, Inc.)のシート抵抗測定装置LEI-1510シリーズは、非接触非破壊でシート測定の測定が可能です。LEI-1510シリーズは、化合物半導体の様々なアプリケーションに対応できるように設計されていて、特に、このLEIテクノロジーによるシート抵抗マッピンググラフは、高周波デバイスの分野において、LEIマップとして広く認識されています。
https://www.semilab-j.jp/products/semiconductor-industry/compound-material-characterization/non-contact-sheet-resistance-eddy/
お問い合わせ先: sakuta.t23@semilabjpn.com

【フォトルミネッセンス En-Vison】
En-Vision(Enhanced Vision)では、転位欠陥、酸素析出物、積層欠陥などのウェハー内部の結晶欠陥を非接触・非破壊で測定できます。通常こうした欠陥は、光学的検査では可視化できません。En-Visionでは、ウェハー深さ方向の検出感度を大幅に向上させ、幅広い密度とアプリケーションをカバーすることで、表面近傍では確認ができない深さ方向の応力起因転位欠陥の検出感度を従来の手法(X-TEM/SECCOエッチング)よりも大幅に向上させています(100倍以上)。 EnVisionは、欠陥サイズ(15nm~サブミクロン)と密度(E6~E10/cm3)の両方でハイダイナミックレンジを提供します。
https://www.semilab-j.jp/products/semiconductor-industry/defect-inspection/en-vision/
お問い合わせ先: sakuta.t23@semilabjpn.com

【非接触CV測定装置】
Semilab SDIのCn-CVシステムは、半導体デバイス・材料の製造プロセス管理と研究開発で使用される最新式で非接触・非破壊の電気メトロロジー装置です。この強力な測定手法では、非接触表面電位プローブ法を照射/非侵襲表面帯電と組み合わせて用いることで、半導体ウェハー、誘電体、界面の特性を示す幅広いパラメータを高精度で測定できる一方で、専用の検査試験装置を製作することに伴うコストと時間を節約できます。 非接触CVプロファイリングメトロロジーの主なアプリケーションは、デバイス製造中の誘電体のモニタリングです。ここで最も重要な機能であり、従来の電気的測定との差別化要因となるのは、事前準備が不要で非接触測定方式であることです。このため、MOSキャパシタの事前準備が不要となり、製造と研究開発の両方の環境で測定コストが削減され、データフィードバックが迅速に実行されます。
https://www.semilab-j.jp/products/semiconductor-industry/compound-material-characterization/non-contact-c-v-profiling/
お問い合わせ先: sakuta.t23@semilabjpn.com

【ライフタイム測定装置】
ライフタイムは、バルク半導体材料の特性の1つであり、過剰キャリアが再結合して平衡に達する前に半導体材料中に存在する平均時間を指します。このパラメータは、「少数キャリア・ライフタイム」、「キャリア・ライフタイム」、「再結合ライフタイム」とも呼ばれます。半導体のライフタイムは、結晶格子が完全で、汚染がない場合に長くなります。一方で、汚染や、導体材料中に不具合がある場合には、ライフタイムは短くなります。このため、ライフタイムをモニターすることが、汚染の検出に効果的です。 セミラボでは、シリコンの他に、ワイドギャップ半導体(SiC,GaN)用のライフタイム測定装置も取り扱っています。
https://www.semilab-j.jp/products/semiconductor-industry/contamination-monitoring/minority-carrier-lifetime-measurement/
お問い合わせ先: sakuta.t23@semilabjpn.com

【フォトルミネッセンス WT】
フォトルミネッセンス測定と反射率測定によりGaN、SiCなどのワイドギャップ半導体中の欠陥と汚染を高速・高解像度で測定する装置です。非接触測定により、LEDなどの品質検査が容易に行えます。
https://www.semilab-j.jp/products/semiconductor-industry/compound-material-characterization/spectral-photoluminescence-measurement/
お問い合わせ先: sakuta.t23@semilabjpn.com
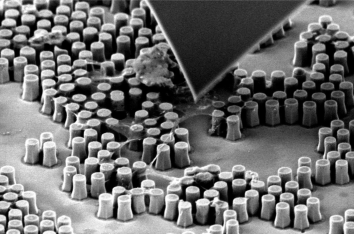
【原子間力顕微鏡 SEM-AFM】
走査型プローブ顕微鏡(SPM/AFM)は、半導体や金属などの微小領域の表面形状や物理量を観察する顕微鏡です。原子間力顕微鏡AFMで、高精度に物質表面の画像が取得できます。SEMとAFMの組み合わせにより、更に高度な解析が可能になります。
https://www.semilab-j.jp/products/research-development/nano-surface-characterization/sem-afm/
お問い合わせ先: sakuta.t23@semilabjpn.com
